Исследование материалов с помощью АСМ методов, основанных на электростатическом взаимодействии
Пример применений 084 (pdf 6.4 Mb)

- Электростатическая силовая микроскопия: измерения и количественный анализ
- Исследования локального поверхностного потенциала с применением однопроходной Кельвин-зондовой силовой микроскопии
- Широкое поле применений: от органическиой фотовольтаики до металлов и полупроводников
Появление методов, основанных на электростатическом воздействии на образец с помощью зонда, значительно расширили область применения атомно-силовой микроскопии. По сравнению с наномеханичесикими методами значительно расширился диапазон изучаемых материалов, который включает теперь не только мягкую органику и смеси полимеров, но и керамику, металлы и полупроводники. Отдельные компоненты составных материалов можно выявить благодаря их отличиям по поверхностному потенциалу, диэлектрическому отклику и локальной проводимости. Количественная характеризация локальных электрических свойств материалов реализована, в частности, в микроскопе НЕКСТ II, в котором имеется полный комплект средств для проведения измерений методами АСМ, основанными на электростатическом взаимодействии, включая Электростатическую силовую микроскопию (ЭСМ) и Кельвин-зондовую силовую микроскопию (КЗСМ) с использованием одно- и двухпроходных методик. В данном обзоре представлены примеры исследования различных образцов с помощью ЭСМ и КЗСМ.
ВВЕДЕНИЕ
Появление атомно-силовой микроскопии (АСМ) [1] и обусловленных ею методик существенно продвинуло потенциал характеризации структуры и свойств материалов на малых масштабах за последние двадцать лет. Уже первые эксперименты по АСМ с использованием микроскопического зонда доказали, что этот метод позволяет получать изображения наноструктур и выявлять морфологию материалов с высоким пространственным разрешением.
В дальнейшем были разработаны методики, дополнившие визуализацию объекта измерением локальных механических и электрических характеристик. Новые возможности с успехом применяются для выявления компонентов неоднородных материалов с высоким пространственным разрешением. Разумеется, для количественной характеризации тех или иных локальных свойств материалов решающую роль играет чувствительность зонда к этим свойствам.
На пути к практической реализации достоверного количественного анализа стоит ряд проблем, решение которых опирается на взаимодействии экспериментальных и теоретических подходов.
В представляемых вниманию читателя примерах применений будут продемонстрированы возможности микроскопа НЕКСТ II в части реализации АСМ методов, основанных на регистрации электростатических взаимодействий между зондом и образцом. После краткого описания этих методов, включающего их теоретическое обоснование, потенциал микроскопа будет раскрыт на нескольких практических результатах, полученных для различных образцов, среди которых: самосборки фторированных алканов на различных подложках, органические материалы для электроники, полимеры, сплавы металлов и полупроводниковые структуры. Будут также рассмотрены важные вопросы оптимизации АСМ методов исследования электрических свойств и количественного анализа данных.
РЕГИСТРАЦИЯ ЭЛЕКТРОСТАТИЧЕСКОГО ВЗАИМОДЕЙСТВИЯ МЕЖДУ ЗОНДОМ И ОБРАЗЦОМ
Группа АСМ методов, основанных на регистрации электростатических сил, действующих между зондом и образцом [2], включает ЭСМ и КЗСМ, а также методы измерения локальных диэлектрических свойств в различных конфигурациях, среди которых микроскопия напряжений Максвелла и другие [3, 4]. Эти методы предназначены для картирования изменений электростатической силы и измерений распределений поверхностного потенциала и диэлектрической проницаемости. Они используют проводящий зонд, на который действует электростатическая сила со стороны образца. Процесс измерений хорошо описывается моделью, в которой зонд и образец образуют две обкладки микроскопического конденсатора (Рис. 1a). При работе по электростатическим методам АСМ зонд приводится в колебания с частотой ωmech с помощью пьезовибратора, а электростатические силы возникают вследствие приложения к зонду постоянного или переменного (на частоте ωmech или другой частоте ωelec) электрического напряжения смещения. В ходе сканирования проводящий зонд испытывает одновременно механическое и электростатическое воздействие со стороны образца. Вклады этих взаимодействий можно разделить, либо регистрируя их в различных проходах сканирования при одинаковой частоте возбуждения (двухпроходная методика) или обойдясь одним проходом, в котором одновременно измеряются механические и электростатические взаимодействия по разным частотным каналам [2].
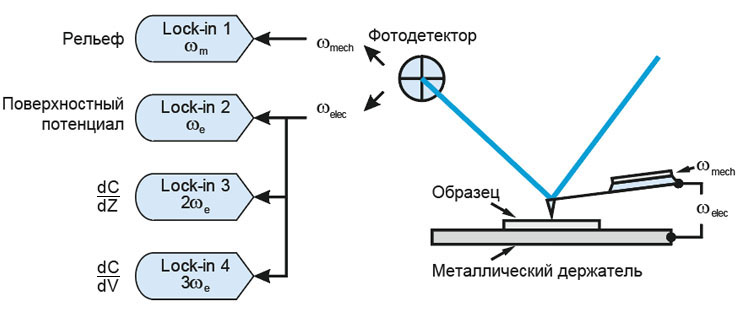
В последнем случае в системе регистрации прибора задействуются несколько синхронных детекторов (Рис. 1b). В этой статье будут рассмотрены оба основных варианта измерения локальных электрических свойств, а их возможности будут проиллюстрированы практическими примерами по изучению одного из стандартных образцов - самосборки полуфторированных алканов F14H20[CF3(CF2)14(CH2)20CH3] на подложке Si [5].
Стриктура и размеры молекулы F14H20 показаны на Рис. 2a. На подложках типа Si или слюды молекулы фторированных алканов, имеющие фторированные и гидрогенизированные участки, самоорганизуются в плоские домены с атомами фтора на границе. Обычная морфология самосборки на подложке Si показана на Рис. 2b.
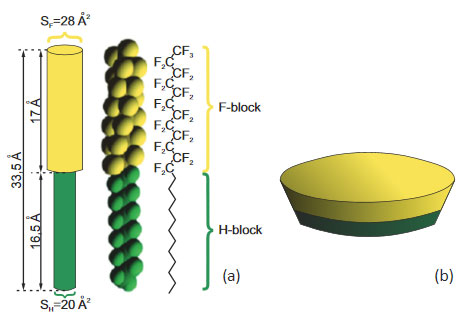
Полный дипольный момент молекулы F14H20 довольно велик (3,1 Д), он направлен вдоль молекулярной цепи, отрицательный полюс которой находится во фторированной части. Вертикальная ориентация молекул, характерная для плоских самосборок на ряде подложек, приводит к появлению заметного потенциала на их поверхности.
Первым из АСМ методов, основанных на регистрации электростатических взаимодействий, рассмотрим ЭСМ.
В этом двухпроходном методе на первом проходе зонд регистрирует профиль поверхности путем измерения механических взаимодействий между зондом и образцом на резонансной частоте изгибных колебаний (1-ая собственная частота) ωmech. На втором проходе зонд следует по ранее полученному профилю, будучи поднят над образцом на высоту 10-40 нм, и при этом регистрируется дальнодействующая электростатическая сила.
Электростатическая сила, действующая между зондом и образцом, дополнительно усиливается за счет приложения к зонду постоянного напряжения смещения. Чувствительность измерений достигается либо путем регистрации изменений фазы и амплитуды колебаний проводящего зонда при постоянной частоте осцилляций ωmech, либо путем измерения изменений частоты и амплитуды при поддержании постоянным значения фазы колебаний зонда. Связь между консервативной электростатической силой и фазой (Θ) и амплитудой (A) колебаний зонда описывается следующими уравнениями [6-7]:

 (1)
(1)где A0 – амплитуда колебаний зондового датчика до возникновения силового взаимодействия между зондом и образцом; Zc - среднее положение кантилевера относительно поверхности в процессе колебаний и

(k и Q - упругая постоянная зондового датчика и его добротность на частоте первого резонанса изгибных колебаний).
Если работа ведется в режиме поддержания фазы постоянной (около 90 градусов), изменения частоты (ω) и амплитуды, обусловленные электростатической компонентой взаимодействия, можно выразить следующим образом:

 (2)
(2)
где Δω = ω - ω0 и ω0 - частота первого резонанса изгибных колебаний зондового датчика (=ωmech).
Уравнения (1) - (2) позволяют найти электростатическую силу по результатам АСМ измерений. Эти данные можно затем использовать для получения различных свойств материала, для которых известны соотношения их связи с электростатической силой.
Такой подход имеет более широкое применение - его можно использовать для анализа механических взаимодействий между зондом и образцом. Главную трудность на этом пути представляет построение реалистичной количественной модели взаимодействий между зондом и образцом, для которой может потребоваться анализ конечных элементов (АКЭ). Для случая электростатических взаимодействий необходимо исследовать образцы нескольких типов с помощью АСМ электростатических методов и затем проанализировать полученные данные. В состав этой группы образцов должны входить диэлектрические слои на проводящей подложке, образцы с молекулярными диполями, металлы с различной работой выхода, полупроводники с различными добавками и другие. Примеры экспериментального исследования, собранные в настоящей статье, можно рассматривать как первые шаги в полномасштабном решении задачи анализа локальных электрических свойств различных материалов.

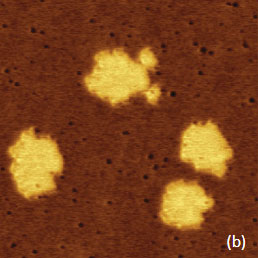
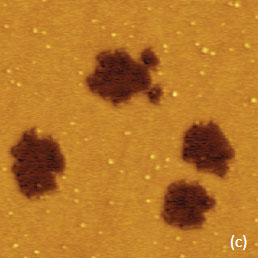

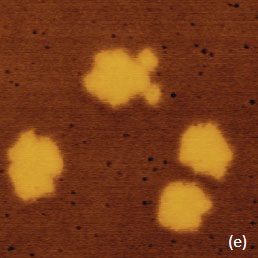

Представление результатов начнем с ЭСМ изображений самосборок молекул F14H20 на подложке Si. Эти структуры уже стали стандартом для верификации аппаратных реализаций метода КЗСМ [3] (Рис. 3a-f). На профиле высоты, показанном на Рис. 3a, видны несколько доменов F14H20, имеющих высоту около 4 нм. Эти домены состоят из плотно упакованных спиралевидных нанообъектов с практически вертикальной ориентацией молекул.
Изображения фазы и амплитуды хорошо коррелируют друг с другом, что согласуется с уравнением (1), а их контраст в областях доменов самосборок F14H20 показывает силу притягивающей электростатической силы, действующей между проводящим зондом и вертикально ориентированными молекулярными диполями. Увеличение притяжения в областях доменов отражается как повышение яркости на изображении фазы и понижение яркости на изображении амплитуды. При увеличении расстояния между образцом и зондом сила притяжения падает, что демонстрируют изображения, полученные при высоте зонда 30 нм (Рис. 3e-f). При дальнейшем отводе зонда от образца пространственное разрешение изображений амплитуды ухудшается. Контраст изображения частоты, полученного при поддержании постоянной фазы колебаний, также обнаруживает увеличение электростатической силы при подводе зонда к областям доменов F14H20 в полном соответствии с уравнением (2).
Изменения амплитуды, фазы и частоты в ЭСМ изображениях отражают вариации локальных электрических свойств образца и поэтому их можно использовать для визуализации состава, однако для количественной характеризации (измерения момента и ориентации диполей в самосборках F14H20) необходима дополнительная обработка данных. В общем случае изменение электрического потенциала (ΔV) на молекулярных диполях выражается следующим образом:

где μ - молекулярный дипольный момент, S - площадь, приходящаяся на одну молекулу; ε0 - универсальная диэлектрическая постоянная, ε - относительная диэлектрическая проницаемость.
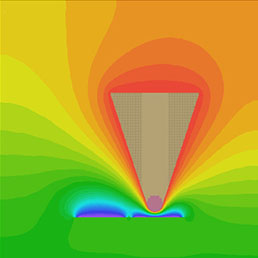

Электростатическую силу, действующую в вертикальном направлении между кончиком зонда и образцом, можно представить в виде
 (3)
(3) (4)
(4)Для расчетов градиента емкости для рассматриваемой геометрии зонд-образец была использована коммерческая программа АКЭ компании Field Precision Inc. Результаты вычислений показаны на Рис. 4a-b. Зависимость электростатической силы от расстояния между зондом и образцом хорошо описывается следующим соотношением включающем два эмпирических параметра B1 и B2:

Это наблюдение позволяет выразить электростатическую силу следующим образом: где градиент емкости C'
где градиент емкости C'

С учетом полученного соотношения существенно упрощается интеграл

в уравнении (1), который теперь можно выразить в аналитической форме. Окончательное решение задачи сводится к уравнению

в которое входят расстояние зонд - образец (Zc) и амплитуда колебаний, регистрируемые в эксперименте, а также свойства материала: градиент емкости и поверхностный потенциал ΔV. Значения материальных параметров можно найти, решив указанное уравнение для серии экспериментов с разными значениями напряжения смещения(Utip). Наш набор ЭСМ данных был получен при напряжении смещения зонда, равном +3 В. Полное решение рассматриваемой задачи будет опубликовано позднее [9].
Описанный подход представляется чрезмерно сложным для случаев, в которых поверхностный потенциал может быть измерен непосредственно, однако прямое измерение возможно далеко не всегда. Измерения поверхностного потенциала могут быть проведены по методу КЗСМ в одно- или двухпроходном режиме. В случае двухпроходного режима на втором проходе проводящий зонд возбуждается электрически на частоте ωelec, а параметром, чувствительным к разности (φ) поверхностных потенциалов зонда и образца, является амплитуда колебаний. Компенсация этой разности (т.е. подавление амплитуды колебаний) осуществляется путем приложения постоянного напряжения смещения к образцу (значение которого и дает поверхностный потенциал) с помощью системы слежения зонда Кельвина.
Двухпроходная методика широко применяется для исследований образцов в специальных средах, однако необходимость отвода зонда от образца на заметное расстояние для регистрации электростатической силы на втором проходе снижает чувствительность и пространственное разрешение метода по сравнению со схемами измерений, в которых зонд находится в непосредственной близости от образца. К этому выводу приводит сравнение экспериментальных данных, полученных в одно- и двухпроходных режимах, которые были представлены нами в одном из предыдущих выпусков "Примеров применения" [10].
В однопроходном режиме, который использует несколько синхронных детекторов, частоте колебаний зонда составляет ωmech, а дополнительное возбуждение на частоте ωelec, много меньшей ωmech, позволяет разделить вклады механических и электростатических сил. Помимо регистрации отклика на основной частоте ωelec, имеется возможность измерения вариаций силы на частотах 2ωelec и 3ωelec при использовании дополнительных синхронных детекторов (Рис. 1b). По вариации силы на частоте 2ωelec можно построить распределение градиента емкости dC/dZ, который связан с локальным диэлектрическим откликом. Отклик на частоте 3ωelec связан со значением dC/dV [11].
Реализация принципов однопроходной КЗСМ достигается путем параллельной регистрации откликов измерительной системы на частотах ωmech и ωelec (<<ωmech) с помощью синхронных детекторов, на которые подается сигнал фотодетектора. В этом случае амплитуда колебаний на нерезонансной частоте ωelec прямо связана с электростатической силой, а способ формирования изображений по этому отклику называется АМ-КЗСМ (АМ - амплитудная модуляция). Дальнодействующий характер электростатической силы приводит к тому, что на эту амплитуду влияют параметры не только кончика зонда, но также и стержня зонда и кантилевера. Повысить чувствительность и пространственное разрешение КЗСМ можно, используя другой подход, который называется ФМ-КЗСМ (ФМ - фазовая модуляция) [10]. В ФМ-КЗСМ электрическое возбуждение производится на низкой частоте, лежащей в полосе ωmech (обычно 10 кГц). Поэтому сигнал фотодетектора содержит компоненты на частоте ωmech и сателлитных частотах ωmech ± ωelec.
Для выделения всех этих компонентов, имеющих узкий спектр, применяется схема с последовательным подключением синхронных детекторов. Первый синхронный детектор предназначен с компонентой на частоте ωmech, которая используется в системе слежения за профилем поверхности. Компонента, обусловленная электростатическим взаимодействием и описываемая значением cosΘ для частоты ωelec, регистрируется вторым синхронным детектором и используется в системе слежения зонда Кельвина. Зависимость cosΘ от силы дается интегралом I(Zc, A), который при малых амплитудах близок к значению градиента силы, что напоминает подход, предложенный в работе [12]. Как было показано ранее, применение градиента силы эквивалентно сужению области взаимодействия между образцом и зондом до промежутка между ними, что приводит к повышению чувствительности и пространственного разрешения по сравнению с АМ-КЗСМ [13-14]. Помимо этого, применяемые в ФМ-КЗСМ дополнительные синхронные детекторы можно использовать для регистрации компонентов отклика на частотах 2ωelec и 3ωelec. Известен также другой вариант ФМ-КЗСМ, в котором влияние параметров стержня зонда и кантилевера на регистрируемое значение электростатической силы снижается за счет использования специального зондового датчика с очень длинным (~100 мкм) зондом.
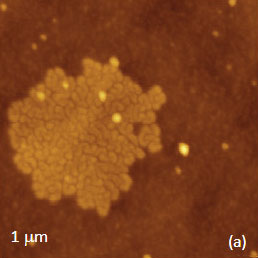
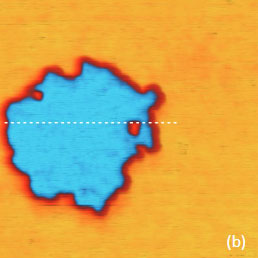


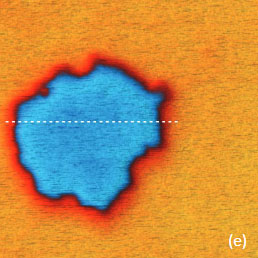

Поверхностный потенциал, АМ

На Рис. 5a-f представлены КЗСМ изображения самосборки F14H20 на подложке Si. Сравнение данных профиля высоты, поверхностного потенциала и амплитуд на частотах 2ωelec и 3ωelec приводит к важным заключениям. Поверхностный потенциал, полученный по ФМ-КЗСМ, больше поверхностного потенциала, полученного по АМ-КЗСМ. Некоторые частицы, окружающие домен F14H20 на изображении рельефа, не видны на изображении по поверхностному потенциалу, но различимы в изображениях амплитуды. Вероятнее всего, дипольный момент в молекулах этих частиц отсутствует или не имеет вертикальной ориентации. В то же время, они влияют на емкость промежутка зонд-образец, что находит свое отражение в изображениях амплитуды.
Значение сигнала на частоте 2ωelec связано с диэлектрической проницаемостью (εωr) и толщиной (h) как функция отношения этих параметров h/εr. Ранее нами было показано, как по сигналу на частоте 2ωelec можно получить распределение диэлектрической проницаемости в тонких пленках полистирена (polystyrene, PS) и поли(винилацетат)а (poly(vinyl acetate), PVAC) [7]. Измерение отклика по dC/ dV успешно применялось для изучения полупроводников, и в дальнейшем этот метод будет распространен на другие материалы. В качестве результата подобных исследований можно упомянуть исследование зависимости контраста dC/dV изображений от состава и концентрации примесей в тестовом образце Si [11].
НЕКОТОРЫЕ ПРИМЕНЕНИЯ ЭСМ И КЗСМ
Ниже будут представлены примеры изучения материалов с помощью ЭСМ и КЗСМ. Во многих случаях качественное изображение удалось получить только по одному из этих методов. Кроме того, ФМ-КЗСМ не всегда превосходит АМ-КЗСМ по качеству изображений поверхностного потенциала.
Чувствительность измерений к электростатической силе и пространственное разрешение изображений во многом определяются подходящим выбором зонда. Поэтому при планировании АСМ электрических экспериментов большое значение имеет практический опыт экспериментатора.
Пример исследования молекулярного упорядочения флюороалканов на различных подложках дает изучение самосборок F14H20
методом КЗСМ [3]. Изображения этих самосборок на подложках из слюды и MoS2 и одномерные сечения изображений показаны на Рис. 6a-f.
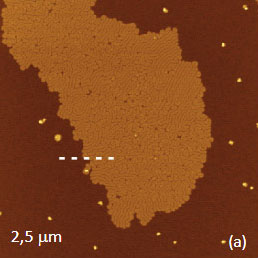
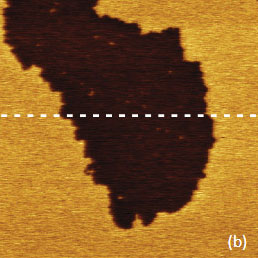

Поверхностный потенциал, ФМ

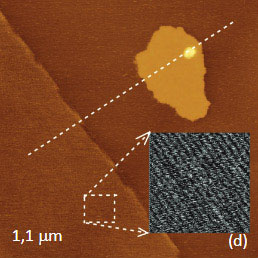


Поверхностный потенциал, ФМ

В случае адсорбции F14H20 на слюде флюороалканы образуют домены, которые состоят из спиралевидных и лентовидных структур, напоминающих структуры, полученные на подложке Si. Высота отдельного домена составляет около 4 нм, а поверхностный потенциал домена относительно слюды - порядка 1 В (Рис. 6b, c) и больше [3]. На другой подложке с атомарно гладкой поверхностью (MoS2) наблюдаются ламеллярные участки с толщиной, близкой к диаметру одиночных молекул фторированных алканов (~0,3 нм) и выступающие островки с высотой 1 нм (Рис. 6d). На вставке к этому рисунку показано увеличенное изображение ламеллярного участка, на котором заметен пространственный период 6,2 нм. Такое же эпитаксиальное упорядочение обычно наблюдается для образцов с подложками из графита, несмотря на то, что кристаллические решетки подложек заметно отличаются. Молекулы фторированного алкана внутри ламеллы ориентированы параллельно подложке, и поэтому поверхностный потенциал на этом участке составляет всего 100 мВ. Потенциал более высоких (1 нм) островков на ~250 мВ выше, чем у примыкающих к ним областей. Этот факт оказался несколько неожиданным, поскольку ранее для образцов F14H20 контраст по поверхностному потенциалу не превышал значений для ламеллярных адсорбатов F14H20 на Si, слюде и графите. Можно предположить, что в данном случае средний вектор ориентации молекулярных диполей сильнее повернут в направлении подложки (MoS2x), однако для подтверждения этой гипотезы нужны более глубокие исследования.
Органические материалы для электроники и фотогальванических элементов
С расширением использования органических материалов для изготовления полевых транзисторов и фотогальванических элементов растет востребованность характеризации их электрических свойств. Ниже представлены примеры визуальной характеризации следующих объектов: слои пентацена и олиготиофена, а также поверхность полимера P3HT (poly-3-hexylthiophene) в смеси с фуллереновой производной PCBM ([6,6]-phenyl-C61 butyric acid methyl ester) на подложке из стекла ITO. Органические полупроводники, особенно пентацен, привлекают большое внимание в качестве материалов для изготовления каналов тонкопленочных транзисторов, поскольку эти устройства демонстрируют подвижность зарядов на уровне 1 cm2V-1sec-1 и коэффициент токовой модуляции порядка 107-108. Великолепные характеристики полевых транзисторов с пентаценовыми пленками обусловлены тем, что направление преимущественной ориентации молекул кристаллитов этих поликристаллических пленок почти перпендикулярно подложке, что обеспечивает высокую степень межмолекулярного π-орбитального перекрытия в плоскости пленки. В структуре транзистора заряд, индуцированный затвором, электростатически ограничен областью границы органика-изолятор; характеристики транзистора во многом определяются структурой и электрическими свойствами нескольких пентаценовых слоев, прилежащих к поверхности диэлектрика.
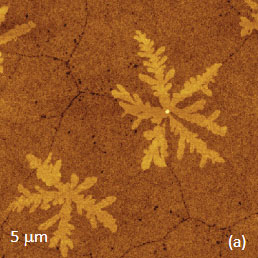



Мы исследовали образец, полученный осаждением пентацена на подложку Si из паровой фазы. На изображении рельефа виден одиночный слой на подложке Si, состоящий из отдельных зерен, разделенных темными границами, а также дендритные частицы, составляющие второй слой. На Рис. 7b-d показаны изображения, полученные методами ЭСМ КЗСМ для того же участка образца. Следует отметить, что изображения амплитуды и частоты для двухпроходной ЭСМ и изображение поверхностного потенциала, полученные однопроходной Кельвин-зондовой силовой микроскопией с фазовой модуляцией (ФМ-КЗСМ), контрастны только на границах дендритов и первого слоя. Ранее эти образцы изучались методом микроскопии касательных напряжений (transverse shear microscopy, TSM) [15], которая чувствительна к разности латеральных сил, действующих на АСМ зонд по разным кристаллографическим направлениям зерен пентацена в первом слое на подложке Si. В TSM изображениях была обнаружена зависимость контраста от типа эпитаксии лежащих под ними пентаценовых доменов.
Кроме того, о связи поверхностного потенциала и особенностей эпитаксии зерен пентацена упоминалось в работе [16]. Было сделано предположение, что изменение контраста обусловлено изменением электростатического связывания между диполями, индуцированными на границах между слоями пентацена, и диполями на границе между пентаценовой пленкой и подложкой.
Сравнение контраста изображений на Рис. 7b-d не противоречит этому предположению [16], и поэтому можно сказать, что вариация контраста дендритов на ЭСМ и КЗСМ изображениях объясняется различиями электростатического взаимодействия их частей, которые лежат на разных зернах первого слоя. Характеризация локальных электрических свойств слоев органических материалов безусловно, полезна для контроля характеристик этих слоев в транзисторных устройствах. Этот тезис подтверждается примером исследования пленок олиготиофена (oligothiophene, OTh) на подложке Si, применяемых в полевых транзисторах, с помощью ЭСМ.
Образцы OTh были получены с помощью центрифугирования на подложке Si из раствора материала в толуоле. Молекула OTh содержит 7 тиофеновых колец, снабженных линейными алифатическими цепочками в качестве концевых групп, что обеспечивает их растворимость в органических растворителях [17]. Упаковка молекул OTh в твердом состоянии аналогична структуре пентацена: длинные оси молекул ориентированы параллельно, а толщина молекулярного слоя определяется длиной молекулы.
Хорошо различимая структурная анизотропия локализует перенос заряда в направлении параллельном границам слоев. Ранее этот материал исследовался для применения в тонкопленочных органических транзисторах, и его характеризация проводилась путем измерения профиля поверхностного потенциала в направлении поперек слоя [18].
На Рис. 8a-f представлены ЭСМ изображения образцов OTh на подложке Si с разным коэффициентом покрытия поверхности. В этом случае изображения, полученные по двухпроходной ЭСМ, имеют гораздо более высокую воспроизводимость и более сильный контраст, чем КЗСМ изображения. На изображении образца с коэффициентом покрытия поверхности OTh менее 1 видны домены с формой, близкой к прямоугольной. Некоторые домены объединяются в более крупные агрегаты.
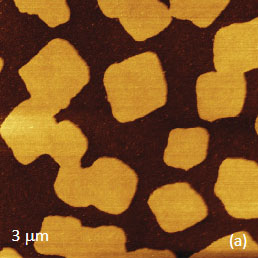

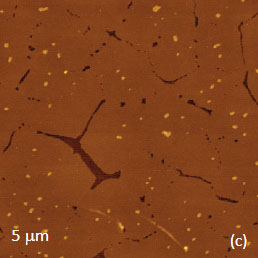

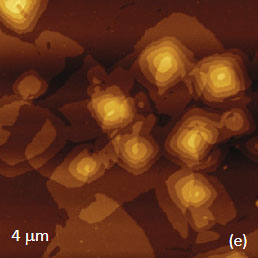

Пониженная яркость этих доменов на изображениях фазы указывает на их более сильное электростатическое взаимодействие с зондом по сравнению с подложкой. При коэффициенте покрытия поверхности, равном 1 (Рис. 8c), на изображении рельефа виден практически плотный первый слой и границы между образующими его зернами. На верхней поверхности первого слоя заметны небольшие капли и волокна материала, которые имеют пониженную яркость по сравнению с лежащими под ними слоем и подложкой (Рис. 8d). Эти компоненты могут привести к неоднородности локальных электрических свойств пленки, что нежелательно при ее использовании в тонкопленочном транзисторе. При увеличении коэффициента покрытия поверхности начинается образование островков и формирование трехмерных кристаллических структур по механизму винтовых дислокаций (Рис. 8e).
Из соответствующего изображения фазы (Рис. 8f) видно, что контраст верхних слоев становится более отрицательным, что усложняет картину электростатического поля образцов. Как мы видим, ЭСМ и КЗСМ исследования сверхтонких пленок таких перспективных материалов для органических транзисторов, как пентацен и олиготиофен, дают ценную информацию об их микроструктуре, электрических свойствах и рабочих характеристиках.
В последние годы наблюдается значительный прогресс в области органических фотогальванических элементов. Мы покажем применение АСМ методов, основанных на измерении электростатических взаимодействий, для исследования фотогальванических элементов на примере изучения смеси P3HT/PCBM с помощью ЭСМ и КЗСМ. Согласно публикациям эффективность смеси P3HT:PCBM составляет 5%, что необычно для органических материалов для солнечных ячеек. PCBM - это фуллереновая производная. Благодаря высокой подвижности электронно-дырочных пар этот материал используется в качестве акцептора электронов во многих органических фотоячейках. Фотогальванический эффект в рассматриваемой смеси полимеров достигается за счет возбуждения электрона на π-орбитали P3HT. Проводимость полимера P3HT обусловлена его кристаллической структурой и упаковкой тиофеновых компонентов в цепи. Тонкопленочный образец P3HT/PCBM был приготовлен центрифугированием из раствора в толуоле на подложку из проводящего стекла ITO.
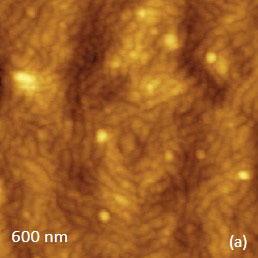



На изображении рельефа (Рис. 9a) видны небольшие выступы с отчетливыми нано-фибриллами шириной 20-30 нм. Эти особенности характерны для полимеров P3HT - они и ранее наблюдались методами ПЭМ [19] и АСМ [20]. Согласно этим результатам при формировании пленки в приповерхностном слое агрегируется преимущественно P3HT.
Контраст ЭСМ изображений фазы и амплитуды обусловлен главным образом нано-фибриллами, при этом контраст изображения фазы выше (Рис. 9b-c). Сравнение изображений рельефа и фазы показывает, что телам нано-фибрилл соответствует более темное изображение фазы, чем промежуткам между ними, что должно объясняться усилением электростатического взаимодействия между зондом и образцом в области фибрилл.
Этот эффект обусловлен влиянием молекулярных диполей, поскольку на изображениях поверхностного потенциала видны аналогичные особенности, а поверхностный потенциал в направлении поперек нано-фибрилл изменяется в диапазоне 0-80 мВ (Рис. 9d). Как мы предполагаем, эти эффекты связаны с распределением диполей, обусловленных ориентацией молекул и электронными связями в материалах, на границах раздела [21].
Полимеры: Термопластический вулканизат и тонкая пленка композита PS-PVAC
АСМ исследования полимерных материалов проводятся как в академическом, так и в прикладном, направлениях на протяжении более 20 лет.

Обычно карты химического состава материалов строятся на основе разностей механических характеристик компонентов материалов, но для этой цели можно использовать также изменение локальных электрических свойств. Это доказывают примеры, приведенные ниже. Композиты из пластмасс и резин с внедрениями частиц сажи представляют большой интерес для технологии ввиду широкого спектра их применений. Исследование отношений структура-свойства и факторов, определяющих те или иные свойства, требует проведения тщательного анализа на микроскопическом уровне, для которого одним из наиболее подходящих инструментов является АСМ. Мы исследовали термопластического вулканизата (thermoplastic vulcanizate, TPV), изготовленного из изотактического полипропилена и резины EPDM с внедрениями частиц сажи, а также ряд других материалов. Схематическое распределение частиц сажи показано на Рис. 10. Структура TPV характеризуется морфологией с разделением микрофаз резины и пластмассы и пространственным распределением частиц сажи (имеют диаметр 20-40 нм), которые образуют проводящую перколяционную решетку. ЭСМ ранее применялась для изучения перколяционных решеток в материалах с внедрениями частиц сажи 1995 [22].
Мы исследовали поверхность образца TPV, полученного путем горячего плавления между двумя плоскими поверхностями, методами КЗСМ и ЭСМ. Наибольший контраст наблюдался для ЭСМ изображений, в то время как изображения по dC/dZ были менее резкими, а изображение поверхностного потенциала оказалось весьма расплывчатым, поскольку композит PP/EPDM является хорошим диэлектриком и слабо реагирует на воздействия, используемые в этом методе. На изображении рельефа видны выступы над основной поверхностью и некоторое количество мелких частиц (Рис. 11a). На ЭСМ изображениях фазы и амплитуды выделяется множество небольших областей с контрастом, намного более высоким по сравнению с прилегающими к ним участками, на которых практически не видны какие-либо детали. Эти области соответствуют расположению частиц сажи, составляющих перколяционную решетку и сильно реагирующих на электростатическое воздействие со стороны зонда. Увеличенные изображения рельефа и амплитуды, подтверждающие это соответствие, приведены на Рис. 11d-e.




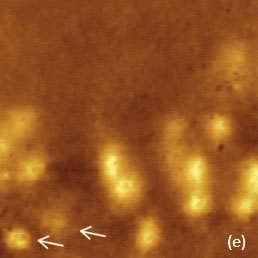
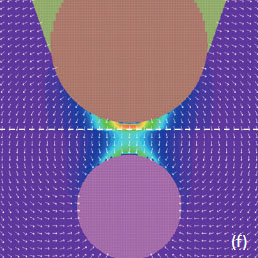
На Рис. 11e белыми стрелками указаны два ярких пятна, расположенные в левом нижнем углу изображения. Источник более яркого пятна хорошо различим на изображении рельефа (Рис. 11d), однако затруднительно указать на этом изображении источник более темного пятна. Вероятнее всего, это пятно обусловлено взаимодействием зонда с частицей сажи, находящейся под поверхностью образца. Для проверки этого предположения было проведено моделирование распределения электростатической силы, действующей между АСМ зондом и проводящей частицей, внедренной в диэлектрическую матрицу, по методу АКЭ (Рис. 11f). Распределение силовых линий, проходящих между зондом и образцом и показанных цветными линиями, показывает, что зонд чувствителен к частицам, расположенным под поверхностью образца.
Еще один пример изучения локальных электрических свойств полимеров дает исследование тонкой пленки композита PS/PVAC на подложке из стекла ITO. Картирование химического состава аналогичного образца было проведено с помощью АСМ микроскопа с методикой конфокальной микроскопии комбинационного рассеяния (ИНТЕГРА Спектра II, НТ-МДТ СИ) путем картирования зон рассеяния, специфических для полимеров. По этим данным композит представляет собой матрицу PS с внедрениями доменов PVAC шарообразной формы. Помимо этого, были получены изображения по dC/dZ от пленок PS/PVAC и их компонентов, что позволило количественно оценить распределение их диэлектрической проницаемости [7]. Здесь будут рассмотрены КЗСМ изображения от пленки PS/PVAC на подложке из стекла ITO (Рис. 12a-f).
Съемка проводилась вблизи царапины на образце, которая была нанесена с помощью острой деревянной палочки. Царапина использовалась для того, чтобы удалить часть слоя полимера без повреждения лежащей под ним подложки, что позволило измерить толщину пленки и создать контраст между подложкой и компонентами полимера. На изображении рельефа (Рис. 12a) хорошо различимы край пленки (расположена слева) и морфология пленки, указывающая на разделение микрофаз. В правой части видна картина, характерная для проводящего стекла ITO.
Согласно профилю, полученному вдоль края пленки, высота пленки составляет около 70 нм. Компоненты полимера различимы по их контрасту с подложкой на изображении поверхностного потенциала: более высокий контраст имеют сферические домены PVAC, внедренные в матрицу PS (Рис. 12b). Тот факт, что потенциал доменов PVAC на ~200 мВ превышает потенциал матрицы PS, можно объяснить более высоким дипольным моментом молекул PVAC и их ориентацией в направлении к поверхности пленки.
Контраст изображения амплитуды (частота 2ωelec, Рис. 12d) обусловлен диэлектрической проницаемостью (ε) композитной пленки и локальными изменениями параметра h/ε, где h - толщина пленки. Метод нахождения распределения диэлектрической проницаемости по данным такого рода был опубликован ранее [7]. Контраст другого изображения амплитуды (частота 3ωelec, Рис. 12e) не столь выражен, но и по нему можно отличить подложку от полимерной пленки.
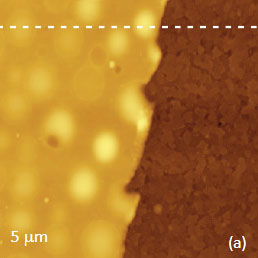
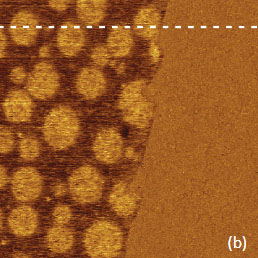

Поверхностный потенциал, ФМ


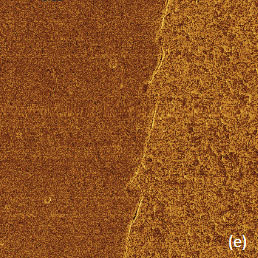
Металлы и полупроводники
АСМ методы, основанные на электростатическом взаимодействии, позволяют изучать неоднородные твердотельные материалы, включая металлы и полупроводники. Отдельные компоненты составных материалов не удается отличить с помощью наномеханических АСМ методов, поскольку обычно твердость таких материалов выше, чем твердость зонда. Однако с помощью КЗСМ можно зарегистрировать различия в работе выхода металлов, как это видно на изображениях двух эвтектических сплавов олова (Sn) с висмутом (Bi) и свинцом (Pb) (приведены ниже), которые используются для пайки.
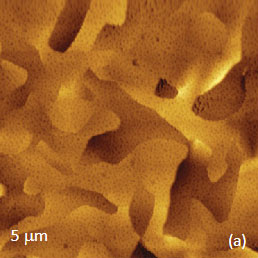


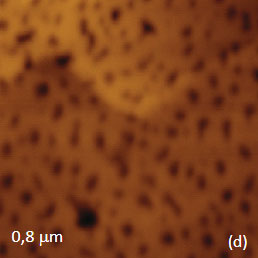
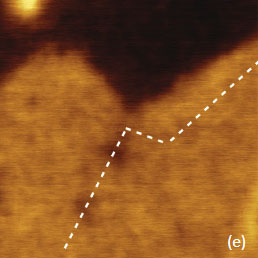

Образцы сплавов были получены путем горячего плавления небольших заготовок между двумя плоскими поверхностями типа слюды или Si при температуре 1900C. После охлаждения образцов до комнатной температуры пленки сплавов были отделены от вспомогательных пластин, и высококачественные поверхности полученных пленок были подвергнуты исследованию с помощью АСМ.
Изображения рельефа и поверхностного потенциала от металлического сплава Bi/Sn показаны на Рис. 13a-f. Топография образца BiSn, полученного горячим плавлением, характеризуется множественными мелкими доменами, размеры которых составляют несколько микрон (Рис. 13). Контраст изображения по поверхностному потенциалу ограничен практически двумя значениями, различающимися на 150 мВ (Рис. 13c). Топография образца BiSn, полученного горячим плавлением, характеризуется множественными мелкими доменами, размеры которых составляют несколько микрон (Рис. 13). Контраст изображения по поверхностному потенциалу ограничен практически двумя значениями, различающимися на 150 мВ (Рис. 13c). Как указывалось в работе [3], контраст потенциала можно объяснить разности работ выхода Bi (4,22 В), Pb (4,25 В) и Sn (4,42 В) [23]. Работа выхода является одной из важных характеристик металлов - она определяет такие свойства, как выход электронов, коррозионную стойкость, фоточувствительность и поверхностный потенциал.
С учетом того, что для измерений использовался зонд с покрытием из Pt (работа выхода Pt - 5,65 V), области на изображении с более низким поверхностным потенциалом можно ассоциировать с доменами Sn. При проведении подобных измерений в контролируемом окружении следует учитывать флуктуации зонда и образца и помнить о влиянии возможных загрязнений. Указанные факторы, несомненно, внесли свой вклад в полученные нами данные КЗСМ, поскольку измерения проводились на воздухе.
До сих пор остается открытым вопрос о возможности использования данных по поверхностному потенциалу для количественного анализа плотности примесей. Профили легирования можно получить по данным КЗСМ, если известны зависимости изменения работы выхода и емкости от типа и концентрации примеси на поверхности и в приповерхностных областях образца [24, 25]. Результаты исследования поверхностного потенциала структуры SDRAM представлены на Рис. 14, 15.
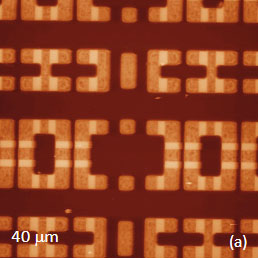
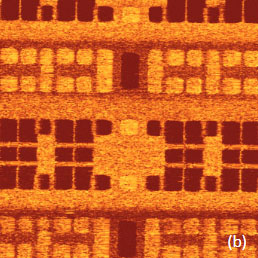
Сканирование крупномасштабных объектов, имеющих регулярную структуру подобно изображению рельефа, показанному на Рис. 14a, должно проводиться с включенной обратной связью. Сравнение изображений рельефа и поверхностного потенциала (метод) показывает, что они весьма различаются - на изображении потенциала можно выявить легированные участки.
Для крупномасштабных структур с резкими перепадами высот метод АМ-КЗСМ предпочтительнее для визуализации, чем метод ФМ-КЗСМ, поскольку последний, использует регистрацию градиента силы, испытывающего сильные флуктуации в областях резкого изменения высоты. Это соображение подтверждается изображениями, приведенными на Рис. 15a-e. Как видим, профиль поверхностного потенциала, полученный методом АМ-КЗСМ, не столь зашумлен, как его аналог для метода ФМ-КЗСМ (Рис. 15e). Следует отметить, что для электростатических методик увеличение радиуса кончика зонда приводит к улучшению отношения сигнал-шум за счет некоторого ухудшения пространственного разрешения.
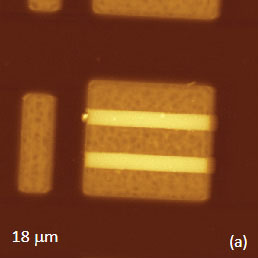
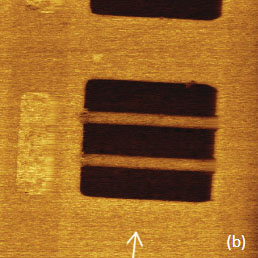
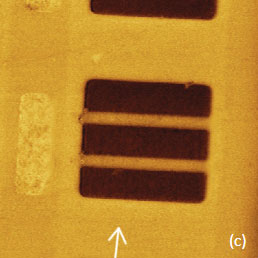
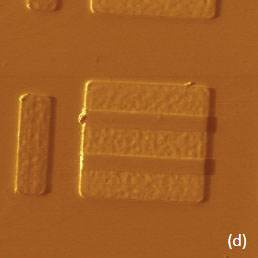
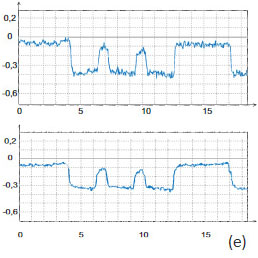
ЗАКЛЮЧЕНИЕ
В статье описан широкий спектр АСМ методов, основанных на электростатическом взаимодействии зонда с образцом, который реализован в сканирующем зондовом микроскопе НЕКСТ. Этот комплекс методов включает однопроходные и двухпроходные методики ЭСМ и КЗСМ, а также методику измерения градиента емкости. Многообещающая, но труднодостижимая, цель разработки этих методик - количественная характеризация локальных электрических свойств материалов, процедуру, которой можно представить как последовательность из нескольких шагов. Первый шаг заключается в регистрации сигнала зонда (изменение частоты, амплитуды или фазы колебаний проводящего зонда, либо непосредственное значение поверхностного потенциала), который однозначно зависит от электростатической силы взаимодействия между зондом и образцом, с достаточной степенью надежности и точности. Следует отметить, что лишь КЗСМ дает непосредственное значение интересующего параметра (поверхностный потенциал) материала. Если полученные изображения имеют достаточный контраст по отношению к компонентам исследуемого неоднородного образца, по измеренным данным можно построить карту состава объекта.
Более трудной является задача извлечения количественной информации из данных ЭСМ и dC/dZ. Ее можно решить путем дополнительного теоретического анализа данных, который описывает, как влияет на отклик зонда изменение электростатической силы, и позволяет определить соответствующее соотношение между силой и свойством материала. В одном из предыдущих сообщений серии "Примеры применений" и в статье [7] нами был предложен метод расчета диэлектрической проницаемости по данным dC/dz.
В настоящей статье приведены примеры анализа ЭСМ изображений по определению локального поверхностного потенциала и значения молекулярного дипольного момента.
Для этого анализа потребовалось привлечение расчетов по методу АКЭ, что позволило получить более реалистическое описание электростатического взаимодействия между образцом и зондом в геометрии измерительной системы АСМ. Тем самым была повышена надежность интерпретации экспериментальных данных, полученных с помощью микроскопа НЕКСТ, что приближает нас к поставленной цели - полной характеризации локальных электрических свойств материалов.
БЛАГОДАРНОСТИ
Благодарим исследователей, любезно предоставивших нам образцы, результаты исследования которых представлены в настоящей статье: проф. M. Moeller и д-р A. Mourran (DWI, Aachen, Germany), д-р G. Haugstad (University of Minnesota, USA), проф. M. Irwin (University of Texas, El Paso, TX).
ЛИТЕРАТУРА
[1] G. Binnig, C. F. Quate, and Ch. Gerber "Atomic force microscope” Phys. Rev. Lett. 1986, 56, 930-933.
[2] Y. Martin, D. A. Abraham, and H. K. Wickramasinghe "High-resolution capacitance measurement and potentiometry by force microscopy” Appl. Phys. Lett. 1988, 52, 1103-10005.
[3] S. Magonov, J. Alexander, and S. Wu "Advancing characterization of materials with Atomic Force Microscopy - based electric techniques. In Scanning Probe Microscopy of Functional Materials: Nanoscale Imaging and Spectroscopy; Kalinin, S. V.; Gruverman, A., Eds.; Springer: Berlin, Germany, 2010; pp 233-300.
[4] H. Yokoyama, and M. J. Jeffery "Imaging high-frequency dielectric dispersion of surfaces and thin films by heterodyne force-detected scanning Maxwell stress microscopy” Colloids Surf. A 1994, 93, 359-373.
[5] A. Mourran, A.; Tartsch, B.; Gallyamov, M.; Magonov, S.; Lambreva, D.; Ostrovskii, B. I.; Dolbnya, I. P.; de Jeu, W. H.; M. Moeller, "Selfassembly of the perfluoroalkyl-alkane F14H20 in ultrathin films”. Langmuir 2005, 21, 2308-22316.
[6] S. Belikov, and S. Magonov "Classification of Dynamic Atomic Force Microscopy Control Modes Based on Asymptotic Nonlinear Mechanics” Proceedings American Control Society, St. Louis, 979-985, 2009.
[7] S. Belikov, J. Alexander, I. Yermolenko, S. Magonov "Atomic Force Microscopy Control System for Electrostatic Measurements based on Mechanical and Electrical Modulation” Amer. Control Conference 2012, 3228-3233.
[8] J. Alexander, S. Magonov, and M. Moeller "Topography and surface potential in Kelvin force microscopy of perfluoroalkyl alkanes selfassemblies” J. Vac. Sci. Technol. B 2009, 27, 903-911.
[9] S. Belikov, J. Alexander, C. Wall and S. Magonov, “Tip-Sample Forces in Atomic Force Microscopy: Interplay between Theory and Experiment”. MRS Online Proceedings Library, Volume 1527, 2013, mrsf12-1527-uu02-04. doi.org/10.1557/opl.2013.616
[10] Application Note "Single-Pass Measurements in Atomic Force Microscopy: Kelvin Force Microscopy and Local Dielectric Studies” Application Note 082, NT-MDT Spectrum Instruments . It can be downloaded from https://www.ntmdt-si.com/resources/applications.
[11] K. Kobayashi, H. Yamada, K. Matsushige, "Dopant profiling on semiconducting sample by scanning capacitance force microscopy”Appl. Phys. Lett. 2002, 81, 2629.
[12] F. Giessibl "Forces and frequency shifts in atomic-resolution dynamic-force microscopy” Phys. Rev. B 1997, 56, 16010-16015.
[13] U. Zerweck, CH. Loppacher, T. Otto, S. Grafstroem, and L. M. Eng "Accuracy and resolution limits of Kelvin probe force microscopy” Phys. Rev. B 2005, 71, 125424.
[14] F. Krok, K. Sajewicz, J. Konior, M. Goryl, P. Piatkowski, and M. Szymonski "Lateral resolution and potential sensitivity in Kelvin probe force microscopy: Towards understanding of the sub-nanometer resolution” Phys. Rev. B 2008, 77, 235427-235429.
[15] K. Puntambekar, J. Dong, G. Haugstad, and C. D. Frisbie "Structural and electrostatic complexity at a pentacene/insulator interface” Adv. Funct. Mater. 2006, 16, 879-884.
[16] V. Kalihari, D. J. Ellison, G. Haugstad, and C. B. Frisbie "Observation of unusual homoepitaxy in ultrathin layers of pentacene films and correlation with surface electrostatic potential” Adv. Mater. 2009, 21, 1-7.
[17] Matthieu Defaux, Fatemeh Gholamrezaie, Jingbo Wang , Andreas Kreyes, Ulrich Ziener, Denis V. Anokhin , Dimitri A. Ivanov, Armin Moser, Alfred Neuhold , Ingo Salzmann, Roland Resel, Dago M. de Leeuw, Stefan C. J. Meskers, Martin Moeller, and Ahmed Mourran "Solution-Processable Septithiophene Monolayer Transistor” Adv. Mater. 2012, 24, 973-978.
[18] S. G. J. Mathijssen, E. C. P. Smits, P. A. van Hal, H. J. Wondergem, S. A. Ponomarenko, A. Moser, R. Resel, P. A. Bobbert, M. Kemerink, R. A. J. Janssen & D. M. de Leeuw1”Monolayer Coverage and Channel Length Set the Mobility in Self-Assembled Monolayer Field-Effect Transistors” Nature Nanotechnology 2009, 4, 674-680.
[19] S. Hugger, R. Thomann, T. Heinzel and T. Thurn-Albrecht "Semicrystalline morphology in thin films of poly(3-hexylthiophene)” Colloid Polym. Sci. 2004, 282, 932-938.
[20] P. Vanlaeke, A. Swinnen, I. Haeldermans, G. Vanhoyland, T. Aernouts, D. Cheyns, C. Deibel, J. D’Haen, P. Heremans, J. Poortmans, and J.V. Manca "P3HT/PCBM bulk heterojunction solar cells: Relation between morphology and electro-optical characteristics” Solar Energy Materials & Solar Cells 2006, 90, 2150-2158.
[21] A. Tada, Y. Geng, Q. Wei, K. Hashimoto, and K. Tajima "Tailoring organic heterojunction interfaces in bilayer polymer photovoltaic devices” Nature Materials 2011, 10, 450-455.
[22] R. Viswanathan, and M. B. Heaney "Direct imaging of the percolation network in a three-dimensional disordered conductor-insulator composite” Phys. Rev. Lett. 1995, 75, 4433-4436.
[23] H. B. Michaelson "The work function of the elements and its periodicity” J. Appl. Phys. 1977, 48, 4729-4733.
[24] A. K. Henning, T. Hochwitz, J. Slinkman, J. Never, S. Hoffmann, Ph. Kaszuba, and C. Daghlian "Two-dimensional surface dopant profiling in silicon using scanning Kelvin probe microscopy” J. Appl. Phys. 1995, 77, 1888-1896.
[25] T. Matsukawa, S. Kanemaru, M. Masahara, M. Nagao, H. Tanoue, and J. Itoh "Doping diagnosis by evaluation of the surface Fermi level using scanning Maxwell-stress microscopy” Appl. Phys. Lett. 2003, 82, 2166-2168.






