Применения
Сверхтонкие пленки: монослои олиготиофена на кремнии
Рельеф (a), отражение при λ= 10.6 мкм (b) и сечение сигнала отражения (c). Образец представлен Dr. A. Mourran (DWI, Aachen, Germany). Измерения проводились Dr. G. Andreev (EVS Co)
Контраст ИК отклика между тонкими и мягкими слоями тиофена на кремнии легко различим. Каждая из пяти 3.4 нм ступеней разрешима. Пространственное разрешение составляет ~ λ/1000.
Фазовый переход пленки VO2: переключение между проводящим и диэлектрическим состояниями
При нагреве пленка VO2 демонстрирует фазовый переход между диэлектрическим и проводящим состояниями. Одни и те же участки были измерены при разных температурах. Светлые участки на изображении ИК отражения соответствуют проводящим доменам, темные участки — диэлектрическим доменам. Выше критической температуры проводящие домены смыкаются и пленка VO2 становится проводящей на макроуровне.
Благодаря выполнению основных частей АСМ из титана система демонстрирует XY дрейф <1 мкм при нагреве от 27 оC до 67 оC, при этом перенастраивать оптику не требуется.
Отражение при 55 °C (a) и при 67 °C (b). λ= 10.6 мкм
Наложенные на рельеф изображения контрастов отражения при 55 оС (a) и при 67 оС (b), λ= 10.6 мкм. Образец представлен prof. Liu (Stony Brook University, New York, USA)
Si-SiO2 калибровочная решетка
Другим примером является решетка, в которой квадратные площадки SiO2 с латеральными размерами 1.5x1.5 мкм и высотой ~20 нм располагаются на Si подложке. Более темные квадратные блоки хорошо различимы на ИК изображениях. Этот контраст отражает разницу реальных компонент диэлектрической проницаемости этих материалов на длине волны 10.6 мкм. Более темный контраст SiO2 площадок на р‑СБОМ карте согласуется с более низким значением их диэлектрической проницаемости (εr = 3.9) сравнительно с ее значением для Si (εr = 11.7).
Рельеф (a) и р‑СБОМ амплитуда (b) решетки Si/SiO2
PS/PVAC пленка на проводящей ITO подложке
Изображение рельефа пленки полистирола с поливинилацетатом (PS/PVAC) на прозрачной подложке (ITO стекло) демонстрирует морфологию, где круглые домены различной высоты включены в относительно плоскую матрицу. Контраст в ИК отражении практически не отмечается на доменах и матрице, в то время как края доменов видны более отчетливо.
Однако на изображении ИК поглощения наблюдается высокий контраст круглых доменов, что позволяет соотнести их с PVAC (полимером, у которого существует линия ИК поглощения вблизи 10.6 мкм). Приведенные данные демонстрируют, что пространственное разрешение отображения ИК отражения и поглощения лежит далеко за дифракционным пределом ИК излучения.
Изображения рельефа (a), контрастов ИК отражения (b) и поглощения (c) пленки PS/PVAC на ITO подложке
Термопластичный вулканизат (ТПВ)
Термопластичный вулканизат является нанокомпозитом, изготовленным из смеси изотактического полипропилена и EPDM каучука, смешанных с частицами технического углерода. Такие образцы легко деградируют при рамановских исследованиях. АСМ-ИК измерения таких образцов не только возможны, но и весьма успешны.
Яркие наночастицы в центральной части изображения рельефа соответствуют углеродному наполнителю. Это подтверждается изображением ИК отражения, где углеродные наночастицы обнаруживают яркий контраст сравнительно с полимерной матрицей.
Изображения рельефа (a) и контраста ИК отражения (b) образца термопластичного вулканизата
Кремниевая микроструктура с p-областями
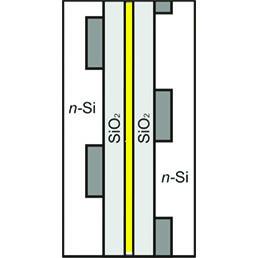 Схема образца
Схема образца
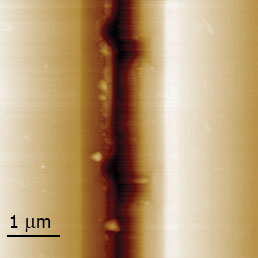 Рельеф
Рельеф
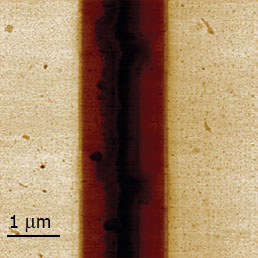 р‑СБОМ Амплитуда
р‑СБОМ Амплитуда
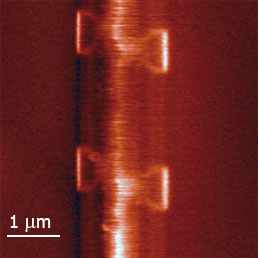 р‑СБОМ Фаза
р‑СБОМ Фаза
В этом примере представлены результаты р‑СБОМ сканировании на длине волны 10.6 мкм Si микроструктуры, содержащей полученные имплантацией BF2 p-легированные области (p~1020 см‑3). Сканирование проводилось по полированному сколу образца, представляющего собой склейку лицевых сторон содержащих p-области Si микроструктур.
р‑СБОМ изображение ясно демонстрирует контраст между легированными и нелегированными областями в кремнии.
В большинстве случаев такой контраст обусловлен разницей в концентрациях свободных носителей в сильно и слабо легированных областях. Действительная часть (ε΄) диэлектрической проницаемости образца определяется главным образом значением εSi=11.7. На длинах волн CO2 лазера εSi является действительной, поскольку в диапазоне 1-200 мкм в нелегированном кремнии поглощение отсутствует, но в легированном Si свободные носители дают вклад в мнимую часть и, соответственно, в фазу комплексной величины εSi.